ユーウィン株式会社は半導体や電子部品で使用される高機能消耗品並びに製造設備をサポートします。
TEL. 03-6450-1690
〒105-0003 東京都港区西新橋三丁目9番3号 内山ビル6階
ユーウィンは半導体や電子部品で使用される高機能消耗品や製造設備をサポートします。
製品一覧

ダイシングテープ・バックグラインディングテープ
半導体や電子部品のダイシング工程やBG工程で使用される高機能テープ。
UVテープ、Non-UVテープなど用途に応じた提案が可能です。
・ダイシングテープ, DCテープ
・バックグラインドテープ, BGテープ
・デンカ エレグリップテープ
![]()
![]()

帯電防止装置
中空糸気体透過膜を介し炭酸ガスを給気する方法で超純水の比抵抗値を制御してダイシング中の静電気による製品へのダメージを抑える帯電防止装置です。
・16L/min~最大116L/minの処理水容量を持つ機種までラインナップ
・インバーターポンプを内蔵し処理水圧力の調整が可能(専用機)
・DIC eFlowシリーズ
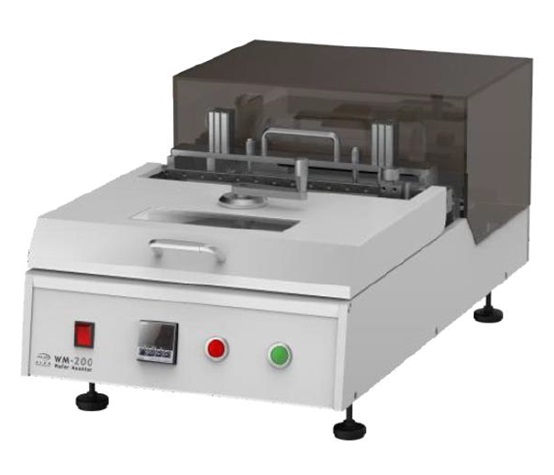
半導体関連装置・部品
・テープマウンター(ダイシングテープ)
・テープラミネーター・テープ剥離機(BGテープ)
・UV照射機 (高圧水銀ランプ・LEDランプ・ブラックランプ)
・スピン洗浄機
・ウエハソーター
・既存装置の改造や保守部品などもご相談ください。

ダイシングブレード
・ハブレスブレード メタルボンド / レジンボンド / 電鋳ボンド
・ハブブレード
・ポリイミドレジンボンドブレード CEPRAX BLADE
超耐熱樹脂ポリイミドをボンドに使用しています。このボンドは熱劣化が少なく剛性が非常に高いことにより耐磨耗性や形状維持に優れています。
CSP基盤/ガラス等/CMOS基盤/セラミックス/超硬等に有効です。
・新開発メタルボンドブレード Gボンドブレード
独自の焼結技術により従来のメタルボンドでは持ち得なかった切れ味、レジンボンドと比べて長寿命の新ボンド
硬脆材料、超硬、鋼、金属材料の精密切断・溝入れ加工用として、チッピングを抑えた高品質な加工に適しています。

グラインディングホイール
・シリコンウエハ用研削ホイール
・SiCウエハ用研削ホイール
ビトリファイドボンドを採用しCMP工程の負担軽減を狙った研削品質の実現を目指しています。#2000〜#30000までラインナップする事で低ダメージや極薄仕上げ研削など目的に応じた提案が可能です。評価をご希望の際はお問い合わせください。

研磨・クリーニングシート POLYMOND
研磨用ダイヤモンド砥粒と熱・薬品・変形に強いポリイミド樹脂を混ぜ合わせた「混練一体成形」の研磨・クリーニングシートです。
ガラス、セラミックス、超硬など硬脆材料研磨に最適
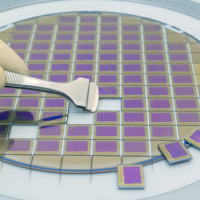
ダイシング・バックグラインド・ウエハ再生 加工サービス
・研削(グラインディング)
・研磨(ドライポリッシュ・CMP)
・切断(ブレードダイシング・ステルスダイシング)
・ピックアップ〜トレイ詰め〜検査
・シリコン、SiC、ガラスなど各種素材に対応可能、少量からご相談ください。

ダイシングセミナー
ダイサー実機を使用するダイシング講習です。アプリケーションを含めた装置オペレーションの習得を目指します。
・習得したいスキルに応じて講習内容や日数を調整可能です。
・2名 1日コース / 2名 2日コースなど

各種ウエハ・ダミーパッケージ
SiC 4H N-type - 6 inch, 8 inch (Dummy / Production)
SiC 4H N-type Epi 650V - 6 inch, 8 inch (Dummy / Production)
ダイシング評価などで使用されるダミーパッケージ
| SiC wafer 6inch n-type - Dummy Grade | Unit | |
| I. Mechanical Specifications | ||
| Diameter | 150 ± 0.2 | mm |
| Surface Orientation | 4.0 toward <11-20>±0.5 | 。 |
| Primary Flat Orientation | <11-20> ± 5 | 。 |
| Secondary Flat Orientation | NA | - |
| Primary Flat Length | 47.5 ± 1.5 | mm |
| Secondary Flat Length | NA | - |
| Surface Finish | Double Side Polish, Si Face CMP | - |
| Wafer Edge | Bevelling | - |
| Surface Roughness | Si-face Ra≤0.2 C-face Ra≤0.5 |
nm |
| Thickness | 350.0 ± 25.0 | µm |
| TTV | ≤10 | µm |
| LTV (10mm*10mm) | ≤5 | µm |
| Bow (absolute value) | ≤40 | µm |
| Warp | ≤60 | µm |
| II. Crystal Specification | ||
| Crystal Form | 4H | - |
| Doping | n-type Nitrogen | - |
| Polytype | ≤30% area | - |
| MPD | ≤5.0 | e.a/cm2 |
| Metal Impurities | ≤1E11 | atoms/cm2 |
| Hex Plates | ≤5% area | - |
| Resistivity | 0.015~0.028 | Ohm.cm |
| Particle (size≥0.3um) | ≤150 | e.a |
| Scratch | Cumulative length ≤225 | mm |
| Edge Exclusion | 3 | mm |
| Lasermark | C-face SEMI M12 | - |
| SiC Epi wafer | 6inch n-type 650V | 8inch n-type 650V | Unit |
| I. Substrate Specifications | |||
| Doping | n-type Nitrogen | - | |
| Resistivity | 0.015~0.025 | Ohm.cm | |
| Diameter | 150 ± 0.2 | mm | |
| Surface Orientation | 4.0 toward <11-20>±0.2 | 。 | |
| Primary Flat Orientation | <11-20> ± 5 | 。 | |
| Secondary Flat Orientation | None | - | |
| Primary Flat Length | 47.5 ± 1.5 | mm | |
| Secondary Flat Length | None | - | |
| Surface Finish | Double Side Polish, Si Face CMP | - | |
| Thickness | 350.0 ± 25.0 | μm | |
| II. Buffer Layer Specification | |||
| Doping | n-type Nitrogen | n-type Nitrogen | - |
| Thickness | 1 | 1 | μm |
| Doping concentration | 1x1018 | 1x1018 | cm³ |
| III. Epitaxy Layer Specifiction | |||
| Doping | n-type Nitrogen | n-type Nitrogen | - |
| Thickness | 5 ± 10% | 5 ± 10% | μm |
| Thickness uniformity | 3% | 4% | σ/mean |
| Doping concentration | 1x1016 ± 15% | 1x1016 ± 15% | cm³ |
| Doping uniformity | 6% | 8% | σ/mean |
| Total usable area | ≥95% (2mmx2mm) | ≥90% (2mmx2mm) | - |
| Killer defect density | 1 | 1.5 | /cm² |
| Post-epi Bow (absolute value) | ≤30 | ≤35 | μm |
| Post-epi Warp | ≤45 | ≤50 | μm |
| Post-epi TTV | ≤7 | ≤10 | μm |
| Post-epi LTV | ≤3 (10mmx10mm) | ≤5 (10mmx10mm) | μm |
| Surface Roughness | Si-face Ra≤0.5 | Si-face Ra≤0.5 | nm |
| Metal Impurities | 1x1011 | 1x1011 | atoms/cm² |
| Scratch | Cumulative length ≤75 | Cumulative length ≤100 | mm |
| Lasermark | C-face SEMI M12 | C-face SEMI M12 | - |